無論是微控制器、現場可程式化邏輯閘陣列 (FPGA),亦或處理器,瞭解這些積體電路的熱性能,對於避免可能導致電路故障的過熱問題一直都是至關重要的。電子系統的小型化和大量產熱的 LED 等元件的廣泛使用使熱分析作為保障產品良好功能和可靠性的作用日益突顯。
但不幸的是,電子產業似乎還未就此新挑戰做好充分準備:事實上,就其零件的熱行為,元件製造商提供的資訊常常極為匱乏,有時甚至僅提供總耗散功率。而Cadence的軟體解決方案可以從熱量層面解決設計問題,從而提高性能。
Cadence Celsius™ Thermal Solver 軟體整合了 Cadence 的IC、封裝和 PCB 實現平臺,其架構經高並行度測試,可在不影響精度的情況下將性能提高 10 倍;從而執行系統分析,以儘早發現並解決因溫度而導致的問題。Cadence 表示其 Celsius Thermal Solver 軟體是首款全面的電熱協同模擬解決方案,適用於積體電路到物理容器的整個電子系統層級。
熱性能
使用 3D 封裝的公司在散熱問題上面臨著極大的挑戰,這些問題可能在設計的最後階段才能發現,而這時的設計變更成本最為昂貴。
因此,熱管理在封裝選擇過程中至關重要,以確保產品的高度可靠性。良好的熱評估需要結合分析計算、經驗分析和熱模擬 。關鍵在於需要確定積體電路在高溫下性能是否可靠。
溫度隨時間變化的關係由兩大定律匯出:牛頓冷卻定律和熱傳導守恆定律。牛頓冷卻定律表示為如下方程:

其中,TB 是物體溫度,TA 是環境溫度,KA 是比例常數。熱傳導守恆定律表示為如下方程:

其中,P 是作用在物體上的能量,m 是品質,c 是比容。牛頓定律指出,一個物體的熱損失率與物體和環境之間的溫差成正比。結合這兩個方程,我們得出以下關係式:

熱阻是需要分析的主要因素。計算條件是在熱平衡(穩態)的狀態下,即:

代入函數,我們得到以下關係式:

式中

是物體和環境之間的熱阻。關鍵在於需要確定積體電路在高溫下是否可靠。不採用特定的分析方法,便無法得到可靠答案。直流模式下,通常必須分析一些參數,如 θJA 熱阻和 TJ 結溫。第一個參數是熱導的倒數,可確定材料的熱絕緣性能。第二個參數結溫是半導體中的一個重要因素,與功耗直接相關。
熱管理工具
用於正確熱管理的主要技術可以總結如下:通常是熱管理組中主熱交換器 (散熱器) 的複合材料;工程師和系統設計師用於測試、設計和分析元件產熱的設計、建模和分析工具;電子封裝用襯底材料。
採用設計軟體,可透過模型和計算流體動力學進行熱分析,從而管理元件和各種接頭的氣流和溫度。
將用於固體結構的有限元分析 (FEA) 技術和用於流體的計算流體力學 (CFD) 技術相結合,Cadence 提供的解決方案使用單一工具對系統進行全面評估。將 Celsius Thermal Solver 軟體與 Voltus IC Power Integrity 和 Sigrity 技術結合用於 PCB 和 IC 封裝時,設計團隊可以結合電氣分析和熱分析並模擬電流和熱流,將系統級熱模擬的精准度提升到新的高度。
熱管理領域的趨勢與半導體、微處理器和電腦技術的發展一致。這些發展是為管理當今電子系統中的過量熱而不斷設計出的解決方案協同作用的結果。
「眾所周知,電氣性能取決於熱特性。例如,器件內的電阻和功率洩漏取決於溫度。溫度也會影響器件的功能性和可靠性。另一方面,熱性能也取決於電氣性能。焦耳發熱會增加系統中的熱源,並且不良設計可能在走線內產生高電流浪湧,引入不利的熱點。對於更好的設計,重要的是要同時考慮這些參數,這也是我們求解器的本質,」 Cadence 系統分析事業部產品總監 CT Kao 表示。
電子工業中對高速和高性能的追求導致了三維 (3D) 積體電路等的發展。憑藉 3D 技術,封裝中微處理器的元件可垂直互連;這推動了多晶片模組 (MCM)、系統級封裝 (SiP 或 SOP) 和疊層封裝結構 (POP) 的產生。3D 處理器結構緊湊,互連較短。這在耗散能級上提高了記憶體的訪問頻寬,並減少了互連。此外,它將異質技術集成在單一封裝內,縮短了上市時間,並具有經濟效益。
然而,3D 也會導致高熱阻,並且空間和時間上的功耗不均勻會導致溫度問題,例如熱點、高溫梯度和熱應力;這需要適用於 3D 微處理器的散熱解決方案,包括液冷微通道熱沉 (MHS)、TSV (矽通孔)、熱介面材料 (TIM) 和空冷散熱器 (AHS)。矽通孔 (TSV) 是一種最先用於 CMOS 圖像感測器的高性能互連技術,可有效降低 3D-IC 的溫度。
Celsius Thermal Solver 軟體基於先進3D結構中的實際電能流動執行靜態 (穩態) 和動態 (暫態) 電熱模擬,最大程度地模擬真實系統的行為。
「我們已確定三種方法來解決設計工程師遇到的熱分析挑戰:以 IC 為中心,以封裝和 PCB 為中心,以系統為中心。以 IC 為中心的方法可以對複雜的晶片級結構 (包括 3D-IC、晶片間鍵合和矽通孔) 進行電熱協同模擬。功率輸入可以由使用者指定,也可以從晶片設計工具導入,該工具可以準確生成晶片上的功率分佈模式。對於以封裝和 PCB 為中心的應用,我們整合了有限元分析和計算流體動力學,可以對真正的 3D 結構和 2D 分層結構進行暫態和穩態分析。對於更大規模的以系統為中心的方法,也整合了有限元分析和計算流體動力學,可進行暫態和穩態分析。此外,還可以根據所獲得的系統級解決方案,為有關封裝或電路板提供詳細的模擬結果,」 CTKao 表示。
電子設計團隊使用 Celsius Thermal Solver 軟體時可儘早分析溫度問題並共用熱分析的屬性,從而減少設計變更,並實現傳統解決方案無法提供的更多評估和設計洞察。此外,Celsius Thermal Solver 軟體可精確詳細地模擬大型系統,能夠評估一切相關元素。這是首款既能模擬如機架等大型結構也能模擬如 IC 等小型結構 (及其功率分佈) 的解決方案。
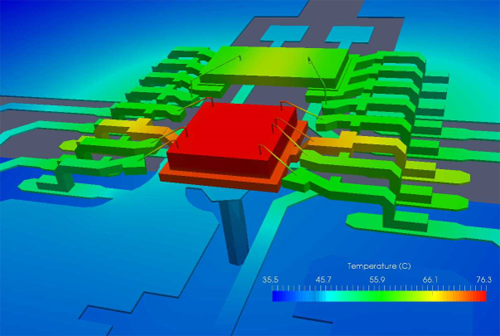
圖:由 Cadence Celsius Thermal Solver 生成的具有金屬互連的封裝內 3D 結構的溫度分佈圖
熱管理為合理的熱控制奠定了基礎,這可能會限制晶片和其他微電子元件的性能,降低了成本和環境方面的可靠性。由於微電子技術日益普及,在日益複雜的情況下對可靠性的要求也越來越高,熱管理在 LED 照明等行業中變得非常重要。透過高效分析改進熱管理,確保電子器件的散熱性能良好,同時提高處理能力和佈局密度。
那麼,究竟如何在 3D-IC 結構中實現熱分析?
線上研討會
在 20 分鐘的交流視頻中,CT Kao 從摩爾定律談到異構集成的發展,並透過技術 demo 直觀展現 3D-IC 結構熱分析中的三大重點問題:
1. |
3D-IC 結構的建模環境 |
|---|---|
2. |
電熱協同模擬 (尤其是焦耳熱分析) 的實現 |
3. |
精准的功率輸入,瞬態模擬的實現 |
歡迎點擊下方視頻進行觀看:
建議在 wifi 環境下觀看並注意調整音量 (中文原聲)
視頻節點摘要:
| 視頻 節點 | 摘要 |
|---|---|
01 : 55 |
後摩爾時代與異構集成 |
05 : 45 |
晶圓級高級封裝流程 |
06 : 25 |
Demo:電熱協同模擬在 3D-IC 結構上的應用 |
16 : 20 |
電熱協同模擬結果與分析 |
講師

Cadence 系統分析事業部 產品總監 CT Kao
原文出處
本文轉載中譯自刊登在 Electronicproducts.com 的文章「System analysis tool mitigates thermal challenges early in the design」,而視頻內容由 Cadence 的 CT Kao 錄製提供。 |
譯文授權轉載出處
長按識別 QRcode,關注「Cadence 楷登 PCB 及封裝資源中心」



