原文:「超越摩爾之路——SiP簡介」,作者:毛忠宇;「System in Package」,作者:Paul McLellan;節選、編輯:Cadence / 江亮
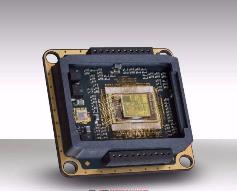
SiP 是組裝在同一個封裝中的兩個或多個不同的晶片。這些晶片可能大不相同,包括微機電系統(MEMS)、感測器、天線和無源元件,以及更顯眼的數位晶片、類比晶片和記憶體晶片。唯一例外的是將單個晶片放入封裝中——但即使一個封裝裡面只有一顆系統單晶片(SoC)也不能稱作 SiP。這也許有點矛盾,但符合一句格言,「系統級總是最高級」。
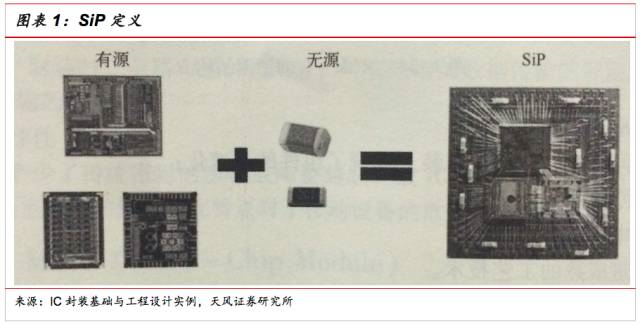
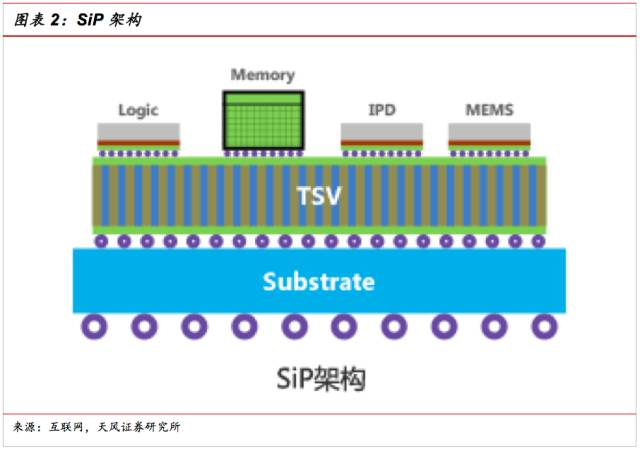
1. SiP —— 超越摩爾定律的必然選擇路徑
摩爾定律確保了晶片性能的不斷提升。眾所周知,摩爾定律是半導體行業發展的「聖經」。在矽基半導體上,每 18 個月實現電晶體的特徵尺寸縮小一半,性能提升一倍。在性能提升的同時,帶來成本的下降,這使得半導體廠商有足夠的動力去實現半導體特徵尺寸的縮小。這其中,處理器晶片和存儲晶片是最遵從摩爾定律的兩類晶片。以 Intel 為例,每一代的產品完美地遵循摩爾定律。在晶片層面上,摩爾定律促進了性能的不斷往前推進。


SiP 是解決系統桎梏的勝負手。把多個半導體晶片和無源器件封裝在同一個晶片內,組成一個系統級的晶片,而不再用 PCB 板來作為承載晶片連接之間的載體,可以解決因為PCB自身的先天不足帶來系統性能遇到瓶頸的問題。以處理器和存儲晶片舉例,因為系統級封裝內部走線的密度可以遠高於 PCB 走線密度,從而解決 PCB 線寬頻來的系統瓶頸。舉例而言,因為記憶體晶片和處理器晶片可以透過穿孔的方式連接在一起,不再受 PCB 線寬的限制,從而可以實現資料頻寬在介面頻寬上的提升。
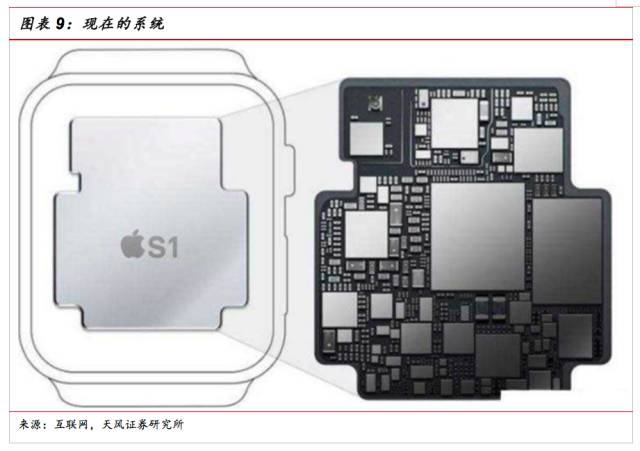

SiP 有多種形式,包括從高端的帶矽通孔(TSV)的矽 interposer 和晶片到低端帶引線鍵合晶片的 BGA(就像老一代 iPhone 中的Ax晶片)。過去,SiP 受到一個悖論的限制:如果 SiP 更便宜,便會有更多人使用它們,但是如果沒有大量的量產應用,成本仍然很高。但是移動電子消費品的市場如此之大,動輒上億,這在一夕之間改變了這種兩難境地。
另一個驅動 SiP 發展的因素是物聯網(IoT)。幾乎任何物聯網設備都包含感測器、計算器件、通信設備(通常是無線的),以及記憶體。這些不可能利用同一製程製造,也就無法在同一個晶片上製造,所以在 SiP 級別進行整合更為可行。物聯網的兩大驅動因素是感測器成本的降低,以及多晶片封裝和模組的低成本。市場容量受到 SiP 成本的影響,而 SiP 成本又會影響到市場容量,兩者相輔相成。
2. SiP —— 為應用而生
2.1. 主要應用領域
SiP 的應用非常廣泛,主要包括:無線通訊、汽車電子、醫療電子、電腦、軍用電子等。
德州儀器公司
德州儀器公司的 MicroSiP 是一個電源設備。尺寸僅為 2.9mm x 2.3mm x 1mm,其中包括安裝在頂部的電感,以減少電路板空間。

Microsemi 公司
Microsemi 已將晶片嵌入到基板中,與之前的版本相比,面積減少了 400%。它具有很高的可靠性,符合植入式元件的 MIL 標準。這種方法也適用于其他需要高可靠性的環境,如航空航太、汽車和工業傳感領域。在此舉一個改進示例——超薄嵌入式晶片,其疊層厚度為 0.5mm,模組總高度約為 1mm(這是分立元件的極限)。
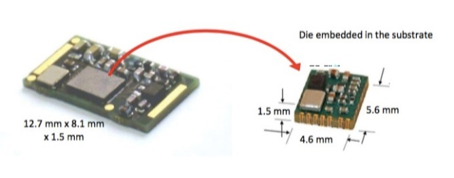
Apple 公司
根據 Chipworks 的 x 光分析表明,蘋果手錶的 S1「晶片」實際上是一個 SiP,其中包含大約 30 個積體電路、許多無源元件,除封裝本身之外,還有一個 ST 加速度計 / 陀螺儀。
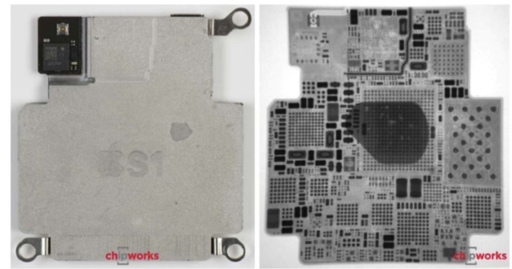
AMD 公司
AMD 的圖形處理器用作矽仲介層和矽通孔。它在 1.011mm2 的仲介層中心安裝了一個 595mm2 的專用積體電路(ASIC),這個ASIC 周圍有四個高頻寬記憶體(HBM)疊層(每個疊層由一個邏輯晶片和四個堆疊在頂部的動態隨機存取記憶體(DRAM)晶片組成)。互連超過 200,000 個,包括銅柱凸塊和 C4 凸塊。仲介層有 65,000 個直徑為 10um 的矽通孔。
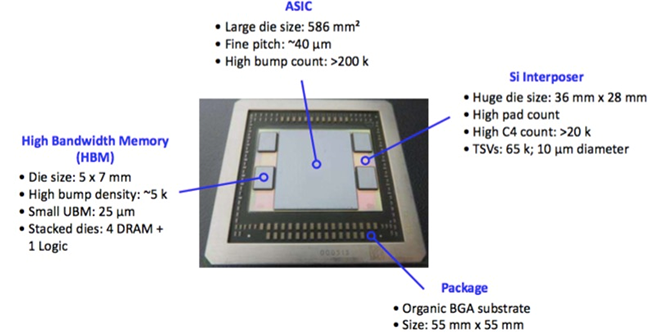
索尼公司
CMOS 圖像感測器(CIS)的最先進技術不是像過去那樣將圖像感測器的正面暴露在光線下,而是將圖像感測器變薄,使其對光線透明,然後將其翻轉到下方的圖像感測器處理器(ISP)晶片上,因此不再需要任何 TSV。感測器接收到的光穿過變薄的晶片背面。
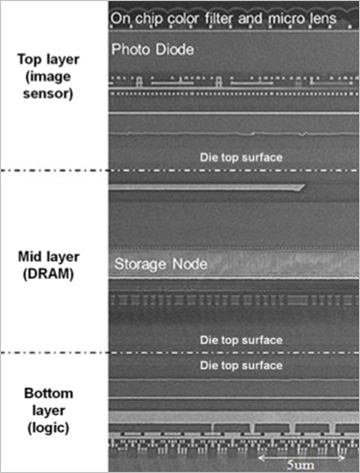
索尼已在三層堆疊結構上更進一步。頂部是圖像感測器,中間是 DRAM 層,底部是 ISP(圖像信號處理器)。來自圖像感測器的信號實際上直接通過 DRAM 層到達處理器,然後返回記憶體。這是第一個使用晶圓接合的商業化三層堆疊結構。實際上,它用在了一款高階手機上,即索尼 Experia XZ,這款手機於 2017 年 2 月在 MWC(世界移動通信大會)大會上推出。圖像感測器和(DRAM)的厚度減薄到了 2.6um!幾十年前,這是電晶體的大小。
索尼不僅是圖像感測器領域的領先者,在包括蘋果手機在內的大多數高端手機領域也是如此。索尼在 2017 年推出的這款手機能達到 960fps,已經相當令人驚豔了。
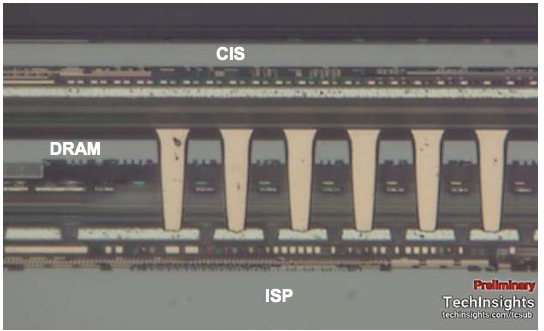
諾基亞公司
諾基亞 SiP 適用于企業路由器,因此不屬於像移動設備這樣對成本非常敏感的市場。它的處理速度可達 100TB/s 甚至更高。含有 22 個晶片,其中包括定制記憶體。整個路由器的尺寸與遊戲機相當,卻可以同時處理令人難以置信的視頻流(Netflix、YouTube等)。
2.2. SiP —— 為智能手機量身定制
SiP 在無線通訊領域的應用最早,也是應用最為廣泛的領域。在無線通訊領域,對於功能傳輸效率、雜訊、體積、重量以及成本等多方面要求越來越高,迫使無線通訊向低成本、可?式、多功能和高性能等方向發展。SiP 是理想的解決方案,綜合了現有的芯核資源和半導體生產工藝的優勢,降低成本,縮短上市時間,同時克服了 SOC 中諸如工藝相容、信號混合、雜訊干擾、電磁干擾等難度。手機中的射頻功放,集成了頻功放、功率控制及收發轉換開關等功能,完整的在 SiP 中得到了解決。
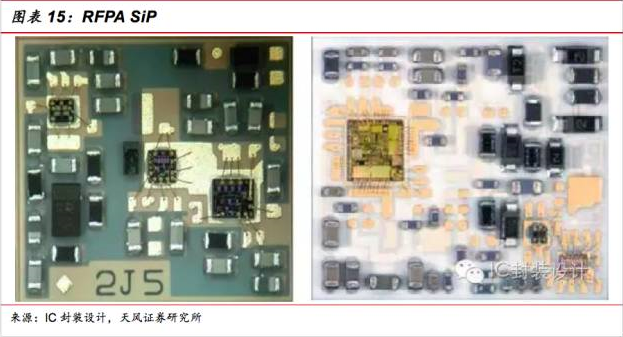
手機輕薄化帶來 SiP 需求增長。手機是 SiP 封裝最大的市場。隨著智慧手機越做越輕薄,對於 SiP 的需求自然水漲船高。從 2011-2015 年,各個品牌的手機厚度都在不斷縮減。輕薄化對組裝部件的厚度自然有越來越高的要求。以 iphone 6s 為例,已大幅縮減 PCB 的使用量,很多晶片元件都會做到 SiP 模組裡,而到了 iPhone 8,有可能是蘋果第一款全機採用 SiP 的手機。這意味著,iPhone8 一方面可以做得更加輕薄,另一方面會有更多的空間容納其他功能模組,比如說更強大的攝像頭、揚聲器,以及電池。

蘋果手錶應用的技術最為先進。在尺寸 26mm x 28mm 的封裝中含有許多器件。手錶對尺寸的嚴格約束意味著不使用 SiP 技術就不可能構建整個系統。下圖是蘋果手錶的電路板,可以更清晰的瞭解該級別的設計:
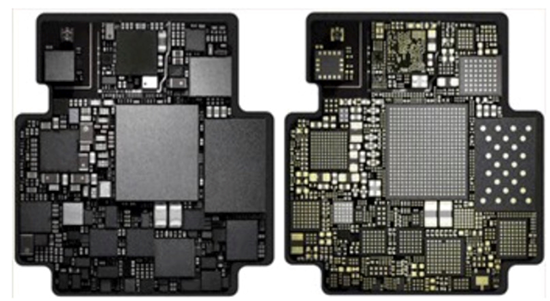
觸控晶片。在 Iphone 6 中,觸控晶片有兩顆,分別由 Broadcom 和 TI 提供,而在 6S 中,將這兩顆封在了同一個 package 內,實現了 SiP 的封裝。而未來會進一步將 TDDI 整個都封裝在一起。iPhone 6s 中展示了新一代的 3D Touch 技術。觸控感應檢測可以穿透絕緣材料外殼,通過檢測人體手指帶來的電壓變化,判斷出人體手指的觸摸動作,從而實現不同的功能。而觸控晶片就是要採集接觸點的電壓值,將這些電極電壓信號經過處理轉換成座標信號,並根據座標信號控制手機做出相應功能的反應,從而實現其控制功能。3D Touch 的出現,對觸控模組的處理能力和性能提出了更高的要求,其複雜結構要求觸控晶片採用 SiP 組裝,觸覺回饋功能加強其操作友好性。
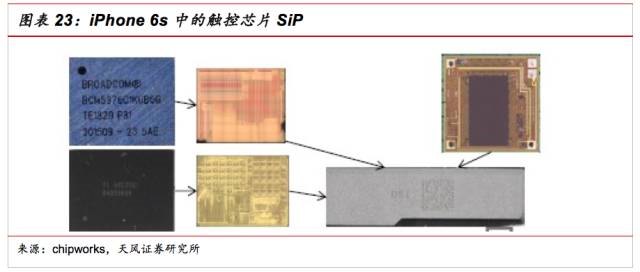
指紋識別同樣採用了 SiP 封裝。將感測器和控制晶片封裝在一起,從 iPhone 5 開始,就採取了相類似的技術。
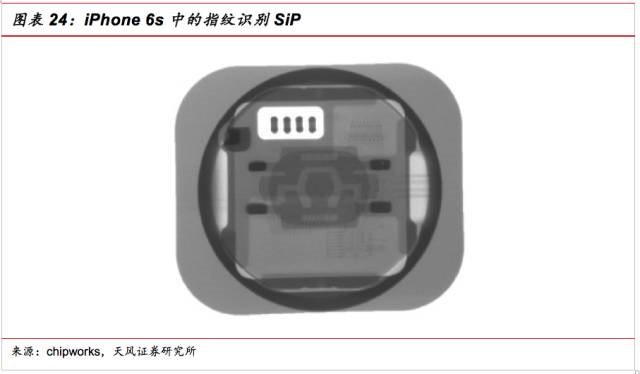
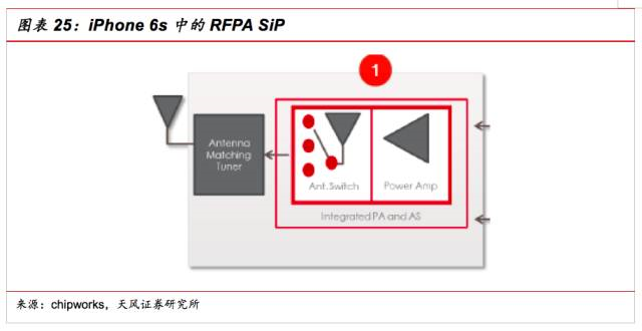
3. 快速增長的 SiP 市場
3.1. 市場規模 & 滲透率迅速提升
2013-2016 年 SiP 市場複合年均增長率為 15%。2016 年全球 SiP 產值約為 64.94 億美元,較 2015 年成長 17.4% 左右;在智慧型手機出貨量持續高位,以及 Apple Watch 等穿戴式產品問世下,全球 SiP 產值估計將繼續增長。

以 2016-2018 年為週期,我們來計算 SiP 在智慧手機市場三年內的市場規模。假設 SiP 的單價每年降價 10%,智能手機出貨量年增 3%。可以看到,SiP 在智慧手機中的新增市場規模的複合年均增長率為 192%,非常可觀。

3.2. 從製造到封測——逐漸融合的 SiP 產業鏈
從產業鏈的變革、產業格局的變化來看,今後電子產業鏈將不再只是傳統的垂直式鏈條:終端設備廠商——IC 設計公司——封測廠商、Foundry 廠、IP 設計公司,產品的設計將同時調動封裝廠商、基板廠商、材料廠、IC 設計公司、系統廠商、Foundry 廠、器件廠商(如 TDK、村田)、存儲大廠(如三星)等彼此交叉協作,共同實現產業升級。未來系統將帶動封裝業進一步發展,反之高端封裝也將推動系統終端繁榮。未來系統廠商與封裝廠的直接對接將會越來越多,而 IC 設計公司則將可能向 IP 設計或者直接出售晶圓兩個方向去發展。
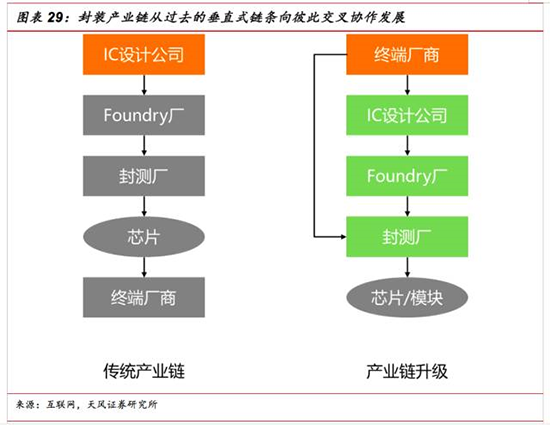
由於封測廠幾乎難以向上游跨足晶圓代工領域,而晶圓代工廠卻能基於制程技術優勢跨足下游封測代工,尤其是在高階 SiP 領域方面;因此,晶圓代工廠跨入 SiP 封裝業務,將與封測廠從單純上下游合作關係,轉向微妙的競合關係。
封測廠一方面可朝差異化發展以區隔市場,另一方面也可選擇與晶圓代工廠進行技術合作,或是以技術授權等方式,搭配封測廠龐大的產能基礎進行接單量產,共同擴大市場。此外,晶圓代工廠所發展的高階異質封裝,其部份制程步驟仍須專業封測廠以現有技術協助完成,因此雙方仍有合作立基點。
4. 總結

SiP 促成了許多產品的實現,尤其是:
手機、平板、筆記本 |
|
固態硬碟(SSD) |
|
物聯網(IoT)設備 |
|
汽車安全系統,包括雷達 |
|
醫用可穿戴設備 |
|
高性能運算(HPC)系統 |
其中,主要的驅動因素便是性能和外形。但對低成本解決方案的需求推動了新封裝設計的採用,這些因素缺一不可。此外,經濟和商業決策也是一個很大的驅動因素,有時還有技術性能方面的考慮(例如 70GHz 雷達)。
隨著摩爾定律這一趨勢減緩,而最先進的工藝不再適用於許多模擬或射頻設計,SiP 會成為首選的集成方法之一,集成是「超越摩爾定律」的一個關鍵方面,而 SiP 將在不單純依賴半導體工藝的面積縮放的情況下,實現更高的集成度。
SiP 代表了行業的發展方向:晶片發展從一味追求功耗下降及性能提升(摩爾定律),轉向更加務實的滿足市場的需求(超越摩爾定律),SiP 是實現的重要路徑。SiP 從終端電子產品角度出發,不再一味關注晶片本身的性能 / 功耗,而去實現整個終端電子產品的輕薄短小、多功能、低功耗等特性;在行動裝置與穿戴裝置等輕巧型產品興起後,SiP 的重要性日益顯現。
本文授權轉載出處
長按識別 QRcode,關注「Cadence 楷登 PCB 及封裝資源中心」



